后疫情时代,一场席卷全球的“缺芯”危机持续蔓延,并且愈演愈烈。芯片,又称为集成电路(integrated circuit,简称IC),或称为微电路(microcircuit)和微芯片(microchip),是现代电子智能产品的核心部件,是接收信号、发布指令的“大脑”。在现今通讯科技高速发展的时代,不可替代的芯片几乎扼住了半导体科技的“咽喉”。新能源汽车、智能手机、电脑显卡、智能电器等等但凡需要使用芯片的电子产品制造行业都因为芯片短缺问题遭受了或多或少的冲击,芯片制造一时间成为大家关注的重点。

图一. 复杂且高精尖的芯片制造技术(网络图)
DUV光刻机
光刻机的核心部件之一是紫外光源。根据公式E = hc/λ(E 为光子能量;λ为光源波长;c为光速,真空中的近似值为3×108m s–1;h为普朗克常数6.62607015×10–34J s),光源的波长越短,其携带的能量越高,那么所需曝光时间越短。换句话说,波长越短,其光刻的“刀锋”更为锋利,光刻工艺的制程将减小。
光刻机根据光源的不同可以分为紫外光源(Ultra-violet Light, 简称UV)光刻机、深紫外光源(Deep Ultra-violet Light, 简称DUV)光刻机和目前最先进的极紫外光源(Extreme Ultra-violet Light,简称EUV)光刻机。最早的光刻机的紫外光源通常采用高压弧光灯(高压汞灯),它可以产生许多尖锐的光谱线,这些光并不是光刻机全部需要的,在安装filter(类似滤光片)之后,就可以过滤掉不需要的波长,只让我们需要的g线(436 nm)或者i线(365 nm)通过。之后经过发展,采用准分子激光的深紫外光源,获得波长更短的深紫外光,比如氟化氪气体(KrF)准分子激光器产生的248 nm深紫外光和氟化氩气体(ArF)准分子激光器产生波长更短的193 nm深紫外光和氟气体(F2)准分子激光器产生的157 nm深紫外光。由激光作为光源的优点就是可以保证光源的高纯度,不需要经过过滤。
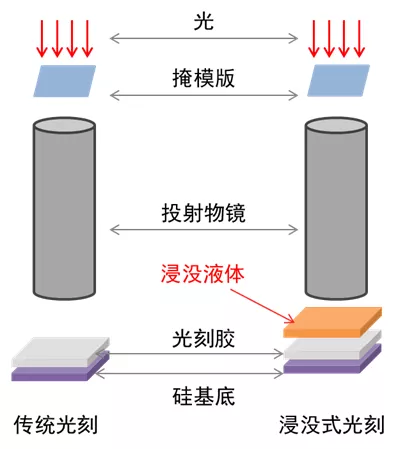
图二. 传统光刻与浸没式光刻简单示意图
当在ArF光源中加入浸没技术,可以进一步减小深紫外光的波长。浸没技术指的是让镜头和硅片之间的空间浸泡在液体之中,由于液体具有大于1的折射率,光的折射之后使得深紫外光的实际波长得到大幅缩小。目前主流的浸没式ArF光刻机使用的液体为纯净水,其折射率为1.44,因而其深紫外光波长最短可以实现193 nm/1.44 = 134 nm。同样荷兰AMSL公司制备的DUV光刻机是目前使用最为广泛的光刻机,ArF光源结合浸没式的光刻机称为ArFi光刻机,采用ArFi光刻机制备芯片的最小制程达到22 nm。然而,在摩尔定律的推动下,半导体芯片的加工制程工艺是需要发展到更低的14 nm,7nm甚至5 nm,3 nm,显然ArFi光刻机已经无法满足这一需求。

EUV光刻机
为了获得更小的芯片制程工艺,必须使用能量更高、波长更短的紫外光源。极紫外光(EUV)逐渐被大家熟知。众所周知,要想实现制造7 nm及以下制程(5 nm及3 nm)的芯片,必须使用极紫外(EUV)光刻机。然而在全世界范围内,现今有能力制造EUV光刻机的公司,只有荷兰的ASML公司,完全处于技术垄断地位。一台EUV光刻机的售价高达1.2 亿美元,即使如此高昂的价格,ASML公司每年生产的EUV光刻机依然供不应求。

图三. ASML 生产的EUV 光刻机(网络图)
目前ASML采用的办法是将高功率二氧化碳激光脉冲照射在直径为30 微米的锡液滴靶材上,激发出高能量的等离子体,其波长为13.5 nm,并被运用为光刻机光源。在这台EUV光刻机中,在真空环境下,将高功率的二氧化碳(CO2)激光打在直径为30 μm的锡液滴上,高功率激光使锡液体汽化,在加热之后锡原子被电离并产生高强度的等离子体,将等离子体发出的EUV辐射收集并汇聚形成光源,这个过程每一步都需要非常精准。
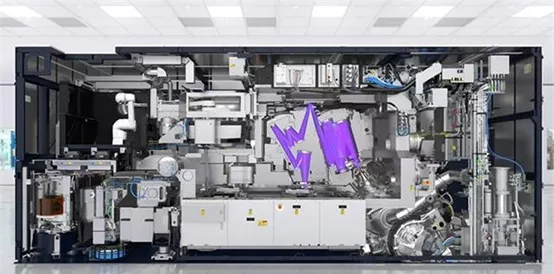
图四. ASML EUV 光刻机的内部复杂的构造(网络图)
光刻机的构造主要包括照明系统(光源和光路)、Stage系统(Reticle Stage 和Wafer Stage)、镜头组(光刻机核心)、搬送系统(Wafer Handler和Reticle Handler)、Alignment系统(WGA, LSA和FIA)。另外,光刻机的工作温度必须维持在恒温23℃,这就需要保证Wafer在恒温和无粉尘颗粒环境下加工,这就必须配备控温控无粉尘颗粒的加工舱体。
光刻机的核心三项技术指标为光刻分辨率(Resolution)、套刻精度(Overlay)和产能(Productivity)。光刻分辨率可用公式R = k1λ/NA,CD是可分辨的最小尺寸,对于光刻技术,R越小越好。k1是工艺常数,λ是光刻机光源的波长,NA代表物镜的孔径,这与光传播介质的折射率相关,折射率越大,NA越大。从上述公式可以得知,提高光刻分辨率的有效策略包括减小紫外光源的波长、降低工艺系数因子和提高投影光刻物镜孔径NA等。当使用EUV光源的改进之后,13.5 nm极紫外光可以实现7~2 nm的芯片加工制程,甚至可以突破2 nm以下。这将会是芯片制造的又一里程碑。
套刻精度的基本含义指的是前后两道光刻工序之间彼此图形的对准精度,这和光刻分辨率密切相关。当芯片上包含的晶体管器件数量增加之后,之间的关联增强,这必须使用多层金属连接,这就需要不同的曝光图形(掩模版)进行反复曝光,这个时候光刻工艺制备集成电路时对对准精度要求非常高,都在纳米级别。目前,ASML的先进光刻机的Overlay能做到1.6 nm左右,在7 nm工艺节点,满足Overlay小于1.5 nm。
当然,提高产能效率同样是光刻机实现其经济效率的重要条件,如何确保光刻机的有效运行、最大程度降低生产芯片流程所耗费的时间是提高产能的关键因素。
EUV光刻机的研发,使得芯片制造工艺制程进一步缩小,再一次验证了“摩尔定律”预言的可推测性。现今的芯片已经包含了数百亿个晶体管器件,电子产品的性能也带来了质的突破。我们非常期待下一代芯片,那又会是什么样的飞跃呢?科技发展永无止境,人们的科技创造的潜力是没有终点,在不断向前、不断深入的挖掘之后,未来肯定又会是一片新天地。
本文有参考微信公众号:
qbdp,《光刻机详解:“恐怖”的光源系统》


