蚀刻工序作为集成电路(IC)制造过程中的一个重要环节,其主要作用是在晶圆基片上准确地构建掩膜上的图形,以保证fab产线后续工序的正常进行;特别是在先进的3D NAND结构存储器芯片(NAND闪存)的生产制程中,蚀刻液作用举足轻重。相比于传统2D NAND结构存储器受到制程持续微缩物理极限的限制,3D NAND将存储单元通过三维方式进行堆叠,从而实现在更小的空间内获得更高的存储容量。目前,市面上已有量产的128层3D NAND闪存芯片销售;据预测,在2025年左右其堆叠层数将达到500层,未来10年内有望达到1000层,其存储的信息量也几何级数的增加。

在NAND闪存的生产过程中,常用SiO2(氧化硅)层作为IC中场效应晶体管的绝缘栅介质。但SiO2的耐磨性和阻挡金属离子注入扩散性较差,需要在其上通过等离子体增强化学气相沉积(PECVD)方式生长一层综合性能更优异的Si3N4(氮化硅)阻挡层,确保最终制备得到的晶体管具有优良的性能和高的良品率。经3D堆砌达到所需的堆叠层数以后,需要通过湿法蚀刻选择去除Si3N4层。由于堆砌的层数较多、高度集成的晶体管线宽越来越小(正在突破10 nm制程),因此蚀刻工序要求蚀刻液对Si3N4/SiO2具有高的蚀刻选择比,否则会破坏3D NAND结构,降低良品率。浓磷酸是Si3N4的优良蚀刻液,但是其对Si3N4/SiO2的蚀刻选择比较低。例如,在典型的蚀刻温度165oC下,浓磷酸的Si3N4/SiO2蚀刻选择比为40左右,根本无法满足fab厂在制备多层3DNAND存储芯片上的需求。
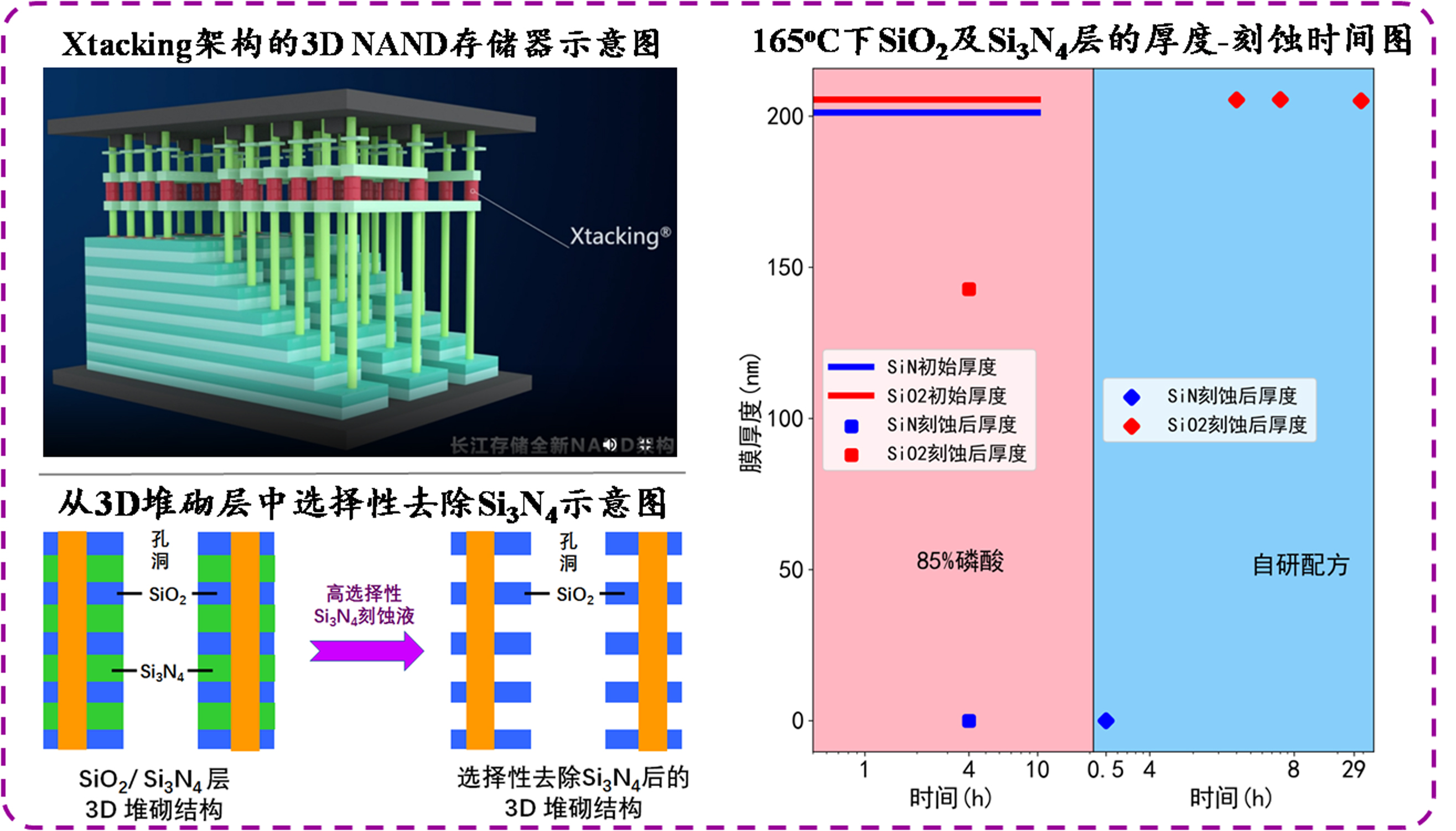
由于我国在3D NAND结构存储芯片的生产制造方面起步较晚,且相关产业链发展还不完善,对Si3N4/SiO2具有高蚀刻选择比的蚀刻液在供货方面一直严重依赖于国外供应商,甚至在近年被国外“卡脖子”。为促进国产高端存储芯片的发展,广东粤港澳大湾区黄埔材料研究院(黄埔材料院)瞄准国家在IC产业方面的这一重大需求,组建了一支功能湿化学品研发团队进行技术攻关。该团队在深入探索其选择蚀刻原理与机制、优化蚀刻液配方后于近期取得了突破,所研发的蚀刻液在不增加基片表面粗糙度的情况下于120oC-175oC范围内均对Si3N4/SiO2具有创纪录的高蚀刻选择比(在165oC条件下其蚀刻选择比超过10000,为当前报道的最高值),可用于制造下一代具有更高存储密度的NAND闪存,且不存在供应链受限的问题,配方中涉及的化学品在国内均有国产供应商,可彻底摆脱国外的技术/产品封锁,保障国内相关产业链的安全。
目前,芯片化学材料中心的功能湿化学品团队正在推进高选择性Si3N4蚀刻液,以及其他BOE蚀刻液、铝蚀刻液和硅蚀刻液等芯片制程用化学品的产业化,为助力广东打造我国集成电路产业发展第三极贡献力量。


